MX68-IR近紅外顯微鏡
利用近紅外光對半導(dǎo)體材料的穿透性特點(diǎn)����,紅外顯微鏡作為芯片制造以及微電子器件的典型無損檢測手段越來越多的受到重視�。通過紅外顯微鏡對硅片穿透可觀察晶體生長過程中的位錯(cuò)�,隱裂痕��;芯片劃片封裝的不良狀況無損分析�����;封裝后的焊接部分檢查;可直接穿透厚度不超過600μm的硅片��,觀察IC芯片內(nèi)部�,觀察內(nèi)部線路斷裂��,崩邊��,崩裂���,溢出等;也應(yīng)用于包括產(chǎn)品晶圓生產(chǎn)內(nèi)部缺陷檢查�,短斷路檢查(燒蝕標(biāo)記�����、壓力指標(biāo)等)、鍵合對準(zhǔn)(薄鍵合電路)��、失效分析和來料測試���。
MX68-IR近紅外一般定義為700-2000nm波長范圍內(nèi)的光線��,對于紅外攝像頭而言硅基傳感器的上限約為1100nm���,銦鎵砷(InGaAs)傳感器大約1800nm左右�����,都是目前在近紅外顯微觀察中使用的主要傳感器,可覆蓋典型的近紅外頻帶�����。大量使用可見光難以或無法實(shí)施的應(yīng)用可通過近紅外成像完成�。當(dāng)使用近紅外成像時(shí)��,水蒸氣�、硅����、部分化合物���、部分藍(lán)膜等特定材料均為透明�,因此紅外顯微檢測被應(yīng)用于半導(dǎo)體行業(yè)的各個(gè)方面�。
MX68-IR近紅外顯微鏡案例應(yīng)用:
-Vcsel芯片隱裂(cracks)���、InGaAs瑕疵紅外無損檢測
-法拉第光隔離器,Faraday lsolator近紅外無損檢測
-die chip 失效分析
-紅外透射Wafer正反面定位標(biāo)記重合誤差無損測量
-硅基半導(dǎo)體Wafer����、碲化鎘CdTe、碲鎬汞HgCdTe襯底無損紅外檢測
-太陽能電池組件綜合缺陷紅外檢測
| |
|
 |
| Vcsel芯片隱裂(cracks) |
Vcsel芯片隱裂(cracks) |
 |
| CMOS器件紅外微觀檢查20X |
CMOS器件紅外微觀檢查10X |
 |
| die chip 失效分析 |
 |
| 硅基半導(dǎo)體Wafer�����、碲化鎘CdTe�、碲鎬汞HgCdTe襯底無損紅外檢測 |
 |
| 太陽能電池組件綜合缺陷紅外檢測 |
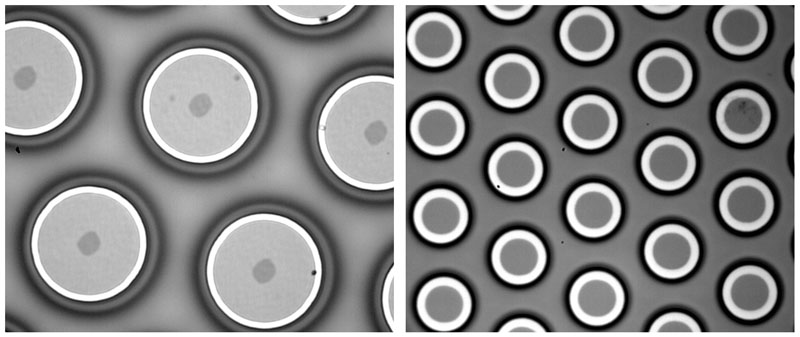 |
| 紅外顯微鏡在---Vcsel行業(yè)的應(yīng)用 |